作為半導體封裝質量監控的重要環節,金球推力測試對保障儲存芯片的可靠性和壽命至關重要。金球推力測試是一種用于測量焊接球與基板之間剪切強度的測試方法,能夠有效評估焊接點的質量和可靠性。

在儲存芯片的封裝過程中,金線鍵合是將芯片與外部電路連接的主要技術,其質量直接影響到整個芯片的性能和壽命。科準測控小編將詳細介紹金球推力測試的原理、標準及操作流程,幫助您全面理解這一關鍵的測試方法。
一、測試原理
金球推力測試是通過機械應力模擬來評估半導體封裝中焊點連接可靠性的關鍵技術。該測試采用水平推力評估球焊點與基板間的結合質量。

測試時,推刀以水平方向對焊球施加力,直到焊球脫落或損壞,通過測量這一過程中所需的最大力值來評估焊球的粘結強度。
二、測試標準與規范
金球推力測試遵循嚴格的標準規范,以確保測試結果的準確性和可比性。
1、測試參數規范
根據行業標準,金球推力測試的主要參數包括:
推刀高度:焊球高度的1/3-1/2處
接觸角度:90±5°
測試速度:50-200μm/s
環境條件:溫度23±5℃,相對濕度RH 45±15%
2、失效模式判定
金球推力測試的失效模式主要分為以下幾種類型:
TYPE 1:金球完整剝離(PASS)
TYPE 2:金球剝離帶少量金屬殘留(PASS)
TYPE 3:基板彈坑(FAIL)
TYPE 4:推刀接觸芯片表面(FAIL)
TYPE 5:部分金球剝離(FAIL)
TYPE 6:金屬層脫落(FAIL)
三、測試儀器
1、Alpha W260推拉力測試機

Alpha W260推拉力測試機是專為微電子封裝可靠性測試設計的高精度設備,特別適合半導體芯片鍵合強度的測試需求。
設備特點:
Alpha W260推拉力測試機具有以下突出特點:
高精度:全量程采用高精度數據采集系統,確保測試數據的準確性
多功能性:支持金線拉力、金球推力、錫球推力和晶片推力等多種測試模式
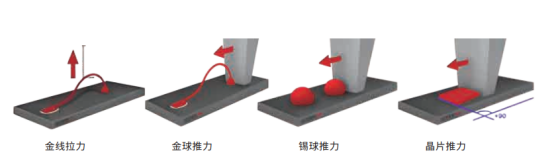
操作便捷:配備專用軟件,操作簡單,支持多種數據輸出格式
智能化:自動數據采集、SPC統計分析、一鍵報告生成
夾具系統:種規格的剪切工具(適用于不同尺寸焊球)

定制化夾具解決方案

四、測試流程詳解
1、試樣準備
將儲存芯片樣品水平固定在測試平臺上,確保測試過程中不會移動。
2、設置參數
確定焊球高度并設置推刀位置,推刀高度應為焊球高度的1/3-1/2處。
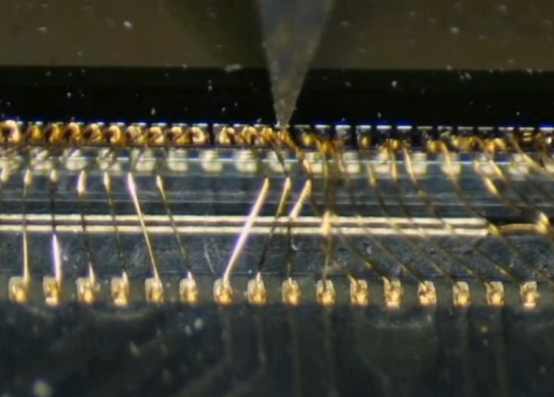
3、推刀水平接近焊球,以100μm/s速度施加推力,直到焊球脫落或損壞。
4、數據記錄
系統自動記錄峰值推力,這是評估焊球粘結強度的關鍵數據。
5、結果分析
在顯微鏡下檢查失效形貌,根據失效模式判定標準判斷測試結果是否合格。
五、應用領域
金球推力測試廣泛應用于多個領域的封裝可靠性評估:
LED封裝測試

IC半導體封裝測試
TO封裝測試
IGBT功率模塊封裝測試
光電子元器件封裝測試
汽車電子領域
航天航空領域
軍工產品測試
以上就是小編介紹的有關于儲存芯片金球推力測試的相關內容了,希望可以給大家帶來幫助。如果您還對推拉力測試機怎么使用視頻和圖解,使用步驟及注意事項、作業指導書,原理、怎么校準和使用方法視頻,推拉力測試儀操作規范、使用方法和測試視頻,焊接強度測試儀使用方法和鍵合拉力測試儀等問題感興趣,歡迎關注我們,也可以給我們私信和留言。【科準測控】小編將持續為大家分享推拉力測試機在鋰電池電阻、晶圓、硅晶片、IC半導體、BGA元件焊點、ALMP封裝、微電子封裝、LED封裝、TO封裝等領域應用中可能遇到的問題及解決方案。